Väitös elektroniikan ja digitaalisten järjestelmien alalta, M.Eng. Obert Golim
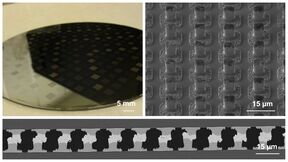
Milloin
Missä
Tapahtuman kieli
Väitöskirjan nimi: Low-Temperature Solid-Liquid Interdiffusion Bonding for Heterogeneous Integration
Väittelijä: Obert Golim
Vastaväittäjät:
Prof. Andreas Leineweber, Technische Universität Bergakademie Freiberg, Saksa
Dr. Anne Jourdain, IMEC (Inter-University Microelectric Centre), Belgia
Kustos: Prof. Mervi Paulasto-Kröckel, Aalto-yliopiston sähkötekniikan korkeakoulu, sähkötekniikan ja automaation laitos
Heterogeeninen integraatio on keskeinen käsite mikroelektroniikkateollisuudessa johtuen erityisesti jatkuvasti lisääntyvän toiminnallisuuden ja kompaktin laitesuunnittelun vaatimuksista. Tähän lähestymistapaan liittyy kuitenkin erityisiä haasteita kokoonpanoprosessien lämpötilasta johtuvien rajoitusten osalta, kun yhdistetään materiaaleja, joilla on erilaiseia fysikaalisia ominaisuuksia. Tämän seurauksena matalan lämpötilan liimausprosessista tulee olennainen osa työkalupakkia, jotta heterogeenisen integroinnin kaikki mahdollisuudet voidaan hyödyntää.
Tässä väitöskirjassa keskitytään Cu-Sn-In-metallurgiaa hyödyntävään solid-liquid interdiffusion (SLID) perustuvaan matalan lämpötilan liimaustekniikkaan. Sn-In seoksen eutektinen käyttäytyminen mahdollistaa liitoslämpötilojen merkittävän alentamisen tyypillisestä yli 250 °C:sta jopa 150 °C:een.
Matalalämpötilaprosessin tuloksena syntyneen liitoksen rakennetutkimus paljastaa homogeenisen mikrorakenteen, jossa on välimetallifaasi, jonka uudelleensulamislämpötila on yli 450 °C, mikä tekee liitoksesta termisesti stabiilin. Liitoksen sähköiset mittaukset osoittavat, että sen vastus on pieni ja verrattavissa tunnettuun Cu-Sn liitos-/juottotekniikkaan, mikä korostaa tämän matalan lämpötilan prosessin kykyä vertikaaliseen integraatioon. Hermeettiset liitokset mahdollistavat mikroelektromekaanisten järjestelmien (MEMS) tai mikro-optoelektromekaanisten järjestelmien (MOEMS) koteloinnin.
Matalan lämpötilan liitosprosesseissa on havaittu erityisiä haasteita, kuten prosessi-integraatioon liittyvät rajoitukset sekä sulafaasin pursottuminen ja mikrorakennevirheiden muodostuminen. Näitä ongelmia voidaan lieventää optimoimalla suunnittelu- ja prosessointiparametreja. Näistä haasteista huolimatta tämän työn tulokset korostavat näkymiä, joiden avulla heterogeenisen integraation tarjoamat mahdollisuudet voidaan hyödyntää lämpötilan aiheuttamat rajoitukset huomioiden.
Avainsanat: Matalan lämpötilan liittäminen, heterogeeninen integrointi, Cu-Sn-In-metallurgia, SLID, interdiffuusio, välimetalliyhdisteet, mikroliitokset ja, hermeettisyys.
Linkki väitöskirjan sähköiseen esittelykappaleeseen (esillä 10 päivää ennen väitöstä): https://aaltodoc.aalto.fi/doc_public/eonly/riiputus/
Ota yhteyttä: obert.golim@aalto.fi; +3585047360225
Sähkötekniikan korkeakoulun väitöskirjat: https://aaltodoc.aalto.fi/handle/123456789/53






